时代芯存半导体科普系列——物理气相沉积(PVD)介绍
薄膜所用的成膜方式, 可分为PVD与CVD两种,物理气相沉积 (Physical Vapor Deposition, 简称PVD) :是指气体(或电浆)透过物理反应的方式, 生成固态薄膜的技术。传统上的PVD可分为蒸镀、溅镀、离子镀。化学气相沉积 (Chemical Vapor Deposition, 简称CVD) :是指利用反应物(通常为气体)产生化学反应, 生成固态薄膜的技术。PVD一般沉积金属膜层(例如:AL、AlCu、Ti、TiN等),CVD一般沉积介电材料(例如:SiN、SiO2等)。
薄膜沉积一般可分为5个步骤:1.孕核 / 成核;2.晶粒成长;3.晶粒聚集;4.细缝填补;5薄膜成长。

溅镀的原理: 靶材(如:AlCu、Ti等),加热器或静电夹用于放置晶圆和加热晶圆;直流电源产生等离子体,提供直流电压去吸引氩离子撞击靶材;射频偏压(可选),产生偏压电压吸引金属离子;遮挡板用于保护腔体壁不被沉积到;真空腔体保持一定压力。

PVD最大的限制是填洞能力较差,容易产生悬突,在洞口转角的地方,由于薄膜沉积的角度广,容易造成突出的现象,悬突的形成会导致洞口封口,在却在洞中形成空洞。
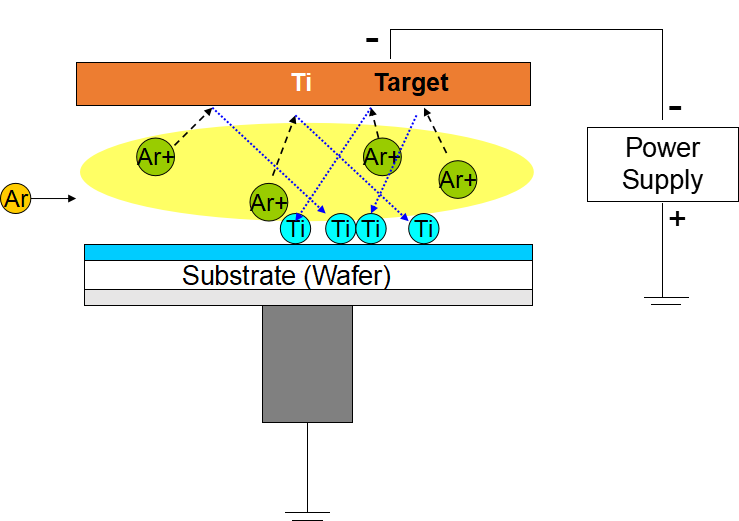
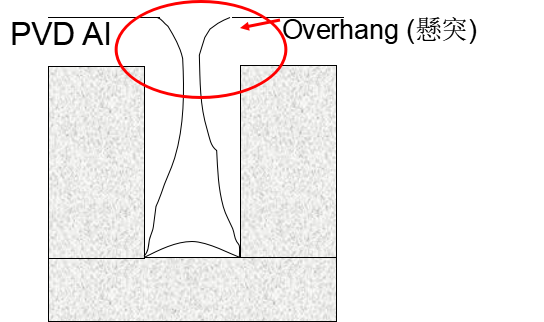
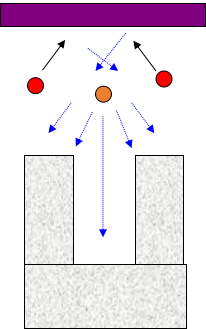
PVD沉积技术,为改善填孔能力,由传统溅射升级为准直器和长腔距两种类型,之后发展为IMP(Ionized Metal Plasma)。
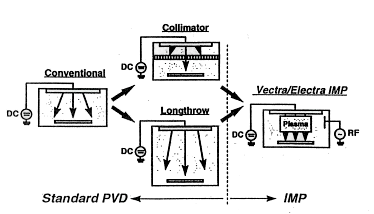
准直器(Collimator) PVD原理是在靶材和圆片之间加一个六角孔状的准直器,用于筛除掉从靶材溅射下来的较大入射角金属材料,准直器腔体沉积速率较慢,PM周期较短。


长距PVD原理是增大晶圆到靶材的距(传统溅射一般为190mm,长距溅射为240mm),筛除掉从靶材溅射下来的较大入射角金属材料,长距腔体沉积速率较慢,均匀性较差,PM周期短。
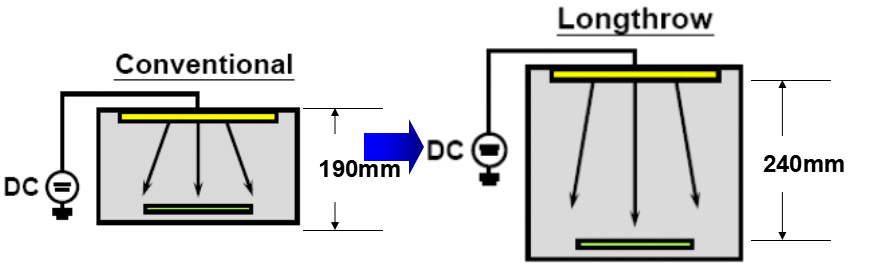
IMP(Ionized Metal Plasma) RF线圈用于电离金属原子,使其变成金属离子,RF BIAS 在晶圆表面形成负偏压吸引金属离子垂直的进入孔内,提高底部台阶覆盖。
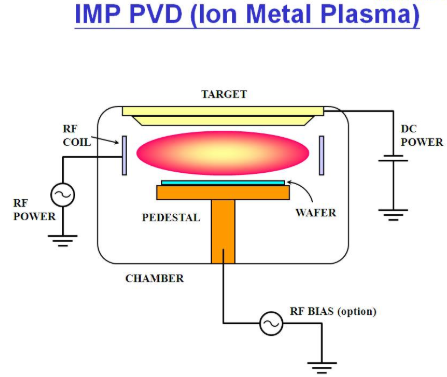
PVD溅射入射角分布

台阶覆盖率
底部台阶覆盖=B/T
侧壁台阶覆盖率=C/T
拐角台阶覆盖率=D/T
举例:
底部台阶覆盖率=B/T=500/1000=50%
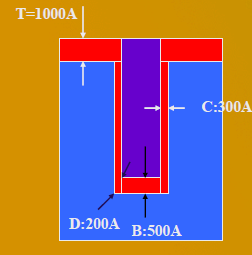

 苏公网安备 32080402000117号
苏公网安备 32080402000117号
